半導体用フォトマスク

半導体用フォトマスクとは
フォトマスクは、半導体製造工程で重要な役割を果たすもので、半導体ウェハ―に回路を転写するための原版です。回路パターンのデータをもとに電子ビームでフォトマスク基板(マスクブランクス)上に回路パターンを作り、その後、化学薬品をなどを使ったエッチングやフォトレジスト(感光材料)剥離、洗浄、測定、検査を経てフォトマスクができあがります。
feature-5
半導体用フォトマスクの種類
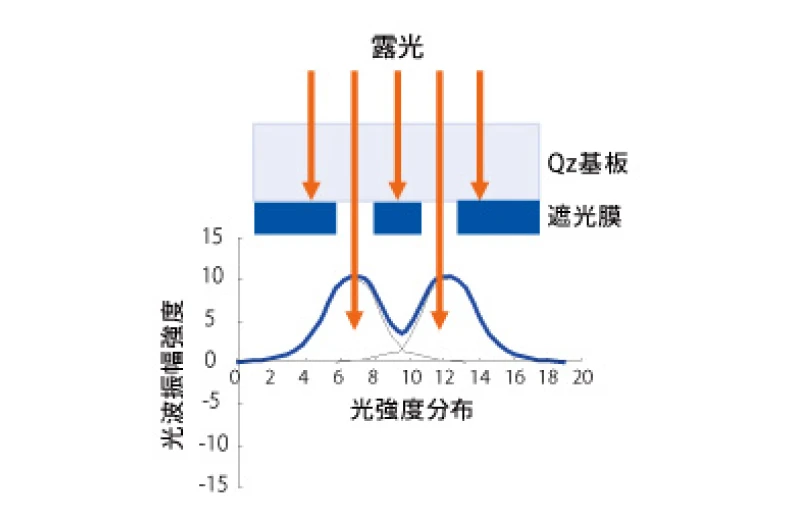
バイナリーマスク
バイナリーマスクとは単純な遮光膜のパターンのみで形成されるマスクです。単純に光を透過する/遮断するという機能のみのマスクで、主として露光波長以上の太さのパターン形成に用いられます。また、先端のハーフピッチ32nm以細の液侵露光においては、ハーフトーン形位相シフトマスクと比較してバイナリーマスクの方に優位性がある事が分かりました。トッパンフォトマスクはブランクスベンダーと共同開発により、より加工性の高い新型バイナリブランクス(OMOG:Opaque MoSi on Glass)を開発、寸法精度および解像性の高いバイナリーマスクの作成を可能にしました。
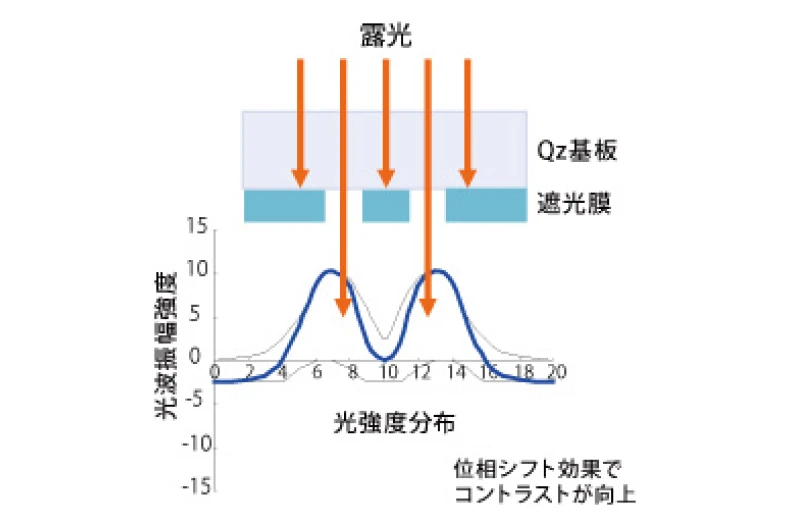
位相シフトマスク
位相シフトマスク(Phase-Shifting Mask:PSM)とは、光の位相や透過率を制御する事で、ウエハーへの露光時の解像度や焦点深度(DOF:Depth of Focus)を改善し、転写特性を向上させたフォトマスクです。露光波長以下のリソグラフィーでは標準的に使用されている技術です。代表的なものに「ハーフトーン型(Attenuated PSM)」や「レベンソン型(Alternative PSM)」等があります。
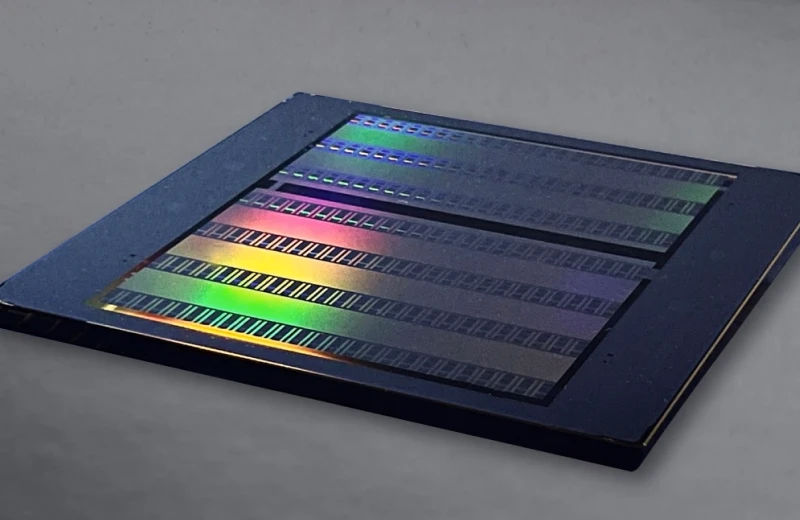
EUVフォトマスク
EUVマスクは次世代フォトリソグラフィーの第一候補として挙げられている技術です。既存のDUV光(ArF:193nm)よりもさらに短い波長のEUV光(13.56nm)を用いるので、より微細なパターンの露光が可能となります。しかし、従来のDUV光を用いた技術とは異なり、EUVはガラスレンズによる光の屈折現象で集光が出来ないため、ウエハー露光機およびマスクは全て反射光学系となります。
feature-5